专注于胶粘剂的研发制造
在电子封装领域,芯片底部填充胶(Underfill)作为一种重要的集成电路封装电子胶黏剂,发挥着至关重要的作用。它主要用于在芯片和基板之间的空隙中填充,能够有效缓解芯片封装中不同材料之间热膨胀系数不匹配带来的应力集中问题,进而提高器件封装可靠性,增强芯片与基板之间的连接强度,提升产品的抗跌落、抗热循环等性能。
随着电子技术的不断发展,芯片封装形式日益多样化,对底部填充胶的性能要求也越来越高。因此,了解芯片底部填充胶的种类以及如何进行选择,对于电子封装工程师和相关研究人员来说具有重要意义。根据其化学组成和应用特点进行分类,底部填充胶可以分为以下几种类型:
一、按固化方式分类
双固化型底部填充胶:可通过光照和温度两种方式进行固化,提供了更灵活的固化选择。
热固型底部填充胶:主要通过加热实现固化,适用于需要较高温度固化的场合。
光固化型底部填充胶:通过光照(如紫外线)实现固化。
二、按填充方式分类
边缘底部填充法:仅在边缘部分进行填充,适用于对填充要求不高的场合。
完全底部填充法:将底部空隙完全填满,提供最大的保护和支撑。
边角绑定填充法:在边角部分进行特定的填充,以提供额外的支撑和稳定性。

三、按应用场景分类
倒装芯片底部填充胶(Flip-Chip Underfill):
用于芯片与封装基板互连凸点之间间隙的填充,此处的精度一般为微米级,对于底部填充胶提出了很高的要求。使用方一般为先进封装企业。
(焊)球栅阵列底部填充胶(BGA Underfill):
用于封装基板与PCB印制电路板之间互连的焊球之间的填充,焊球之间的间隙精度为毫米级,对底部填充胶要求相对较低。
四、按材料成分分类
聚氨酯基底部填充胶:具有优异的机械性能和化学稳定性,适用于需要承受高拉伸和压缩力的场合。
环氧树脂基底部填充胶:这是最常见的类型,环氧树脂具有优异的粘结性能和耐候性,适用于多种封装场景。
其他材料基底部填充胶:如丙烯酸酯、丁基橡胶等,这些材料具有各自的特性,可以根据具体需求进行选择。
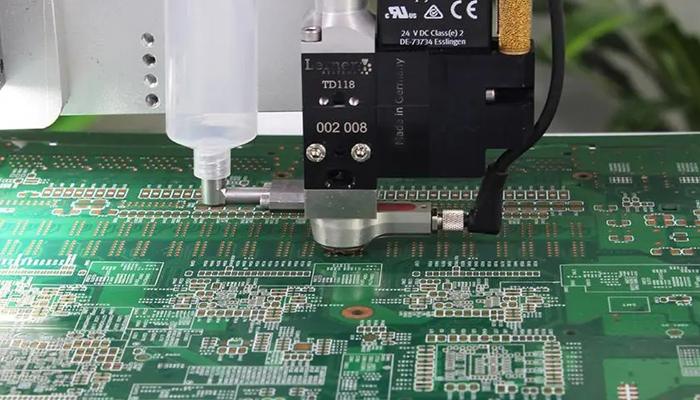
研泰化学深耕电子胶粘剂领域近二十载,针对芯片封装胶推出了系列高性能产品,可以满足不同应用场景的需求:
高可靠性环氧树脂封装胶:耐高温、耐低温、耐湿热,适用于汽车电子、工业控制等严苛环境。
低应力有机硅封装胶:柔韧性好,能有效缓解应力,适用于功率器件、LED等对应力敏感的产品。
快速固化UV胶: 固化速度快,适用于需要快速封装的场景。
芯片底部填充胶的种类繁多,选择合适的底部填充胶取决于具体的应用要求,例如工作温度范围、湿度环境、所需固化时间和成本等因素进行综合考虑。此外,制造厂商也可根据自身的生产工艺来选择最适合的产品。在选择时,应该评估产品的性能指标,包括流动性、粘接力、热膨胀系数匹配度等,同时也要考虑供应商的技术支持和服务质量。
研泰化学深耕电子胶粘剂领域近二十载,可为用户提供创新、专业、定制化整体电子胶粘应用解决方案。在应用合作接洽中,研泰不仅提供优质的产品,更提供专业的技术支持和服务,会根据不同的产品结构,材质以及生产工艺的要求为厂商定制胶黏剂解决方案!欢迎通过在线客服、网站留言、来电、邮件等方式联系研泰化学,将1V1免费为您提供技术服务。