专注于胶粘剂的研发制造
底部填充胶(Underfill)作为一种重要的集成电路封装电子胶黏剂,在先进封装如2.5D、3D封装中,用于缓解芯片封装中不同材料之间热膨胀系数不匹配带来的应力集中问题,进而提高器件封装可靠性。底部填充胶是一种低黏度、低温固化的毛细管流动底部填充料,流动速度快,工作寿命长,翻修性能佳,其在加热的条件下可以固化,将底部空隙大面积填满,从而达到加固的目的,增强封装芯片和PCBA之间的抗跌落性能。
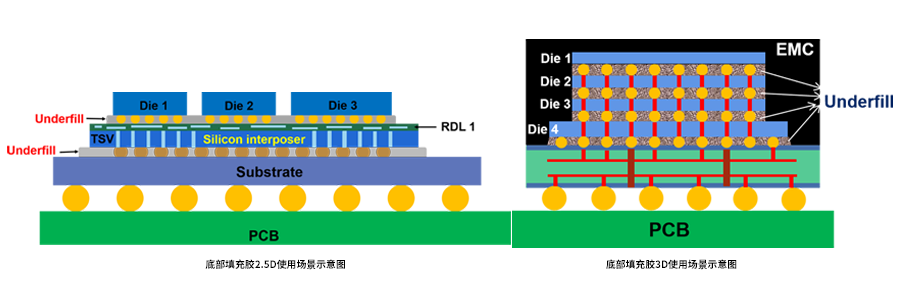
从使用场景上来看,底部填充胶分为两种,一种是倒装芯片底部填充胶(Flip-Chip Underfill),用于芯片与封装基板互连凸点之间间隙的填充,此处的精度一般为微米级,对于底部填充胶提出了很高的要求,使用方一般为先进封装企业;另一种是(焊)球栅阵列底部填充胶(BGA Underfill),用于封装基板与PCB印制电路板之间互连的焊球之间的填充,焊球之间的间隙精度为毫米级,对底部填充胶要求相对较低。
一、关于底部填充材料
底部填充胶是由多种成分组成,不同成分对材料的作用不同。从工艺角度看,较低的黏度可以缩短填充速度,需要具备合适的固化温度和固化时间,一般还应易于返修;从可靠性角度而言,底部填充胶需具备良好的填充效果以减少气泡和空穴,具备与基板和焊点之间的兼容性,以及重新分配不同组件的热应力;同时需要满足较高的表面电阻,耐温耐湿能力,以及耐热冲击能力等。
底部填充胶的性能指标主要包括以下几个方面:粘度(Viscosity),直接影响工艺的填充性能和填充时间,一般底部填充胶的粘度越低,加工的效率越高;热膨胀系数(CTE),因为硅芯片(2.5×10-6 /K)和印刷电路板(18×10-6 /K~24×10-6 /K)之间的热膨胀系数差别很大,解决温度变化产生的内应力问题是底部填充胶发明的初衷,应在保证其他性能的前提下尽可能减小热膨胀系数;玻璃化转变温度(Tg)和弹性模量(Elastic Modulus),玻璃化转变温度和弹性模量直接影响器件的耐热机械冲击的能力,而这两者对性能的影响较为复杂且会相互制约,需要找到平衡点以得到合适性能的产品。
底部填充胶的主体材料一般是环氧树脂,通常包含双酚A、双酚F等类型的环氧树脂。除去环氧树脂,底部填充胶一般还包含填料、硬化剂、催化剂、助粘剂、阻燃剂、颜料、增韧剂和分散剂等成分。底部填充胶所使用的填料一般为球型二氧化硅,主要为了降低热膨胀系数、增强模数和降低吸湿性等。底部填充胶所含成分及其功能如下图所示,这些成分的组合以增强底部填充胶固化后性能为目的,大大提高了倒装芯片封装的可靠性。

二、底部填充工艺
倒装芯片的底部填充工艺一般分为三种:毛细填充(流动型)、无流动填充和模压填充,其各自的工艺流程如下图。一般底部填充工艺过程主要包括两个工艺,即初始底部填充工艺和随后的固化工艺。
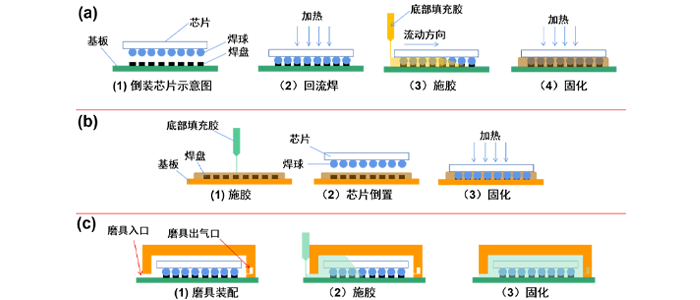
三、底部填充胶应用中常见问题及解决方法
1)胶粘剂固化后会产生气泡
气泡一般是因为水蒸汽而导致,水蒸气产生的原因有SMT(电子电路表面组装技术)数小时后会有水蒸气附在PCB板(印制电路板)上,或胶粘剂没有充分回温也有可能造成此现象。常见的解决方法是将电路板加热至110℃,烘烤一段时间后再点胶;以及使用胶粘剂之前将胶粘剂充分回温。
2)胶水渗透不到芯片底部空隙
这种情况属胶水粘度问题,也可以说是选型问题,胶水渗透不进底部空隙,只有重新选择合适的产品,专业厂家底部填充胶,流动性好,在毛细作用下,对BGA封装模式的芯片进行底部填充,再利用加热的固化形式,快达3-5分钟完全固化,将BGA底部空隙大面积填满(填充饱满度达到95%以上),形成一致和无缺陷的底部填充层,并且适合高速喷胶、全自动化批量生产,帮助客户提高生产效率,大幅缩减成本。
3)胶水不完全固化或不固化
助焊剂残留会盖住焊点的裂缝,导致产品失效的原因检查不出来,这时要先清洗残留的助焊剂。但是芯片焊接后,不能保证助焊剂被彻底清除。底部填充胶中的成分可能与助焊剂残留物反应,可能发生胶水延迟固化或不固化的情况。要解决由助焊剂影响底部填充胶能否固化的问题,首先要防止助焊剂的残留,以及要了解胶水与助焊剂的兼容性知识,底部填充胶具有工艺简单、优异的助焊剂兼容性、毛细流动性、高可靠性边角补强粘合等特点,并且专业厂家可以全方位提供用胶方案,有效解决此问题。

四、研泰化学专业研发生产底部填充胶
在倒装芯片封装中,硅芯片使用焊接凸块而非焊线直接固定在基材上,提供密集的互连,具有很高的电气性能和热性能,倒装芯片互连实现了终极的微型化,减少了封装寄生效应,并且实现了其他传统封装方法无法实现的芯片功率分配和地线分配新模式。研泰化学技术团队根据累积经验案例创新研发的MX-62系列底部填充胶,从搭载无源元器件的大型单芯片封装,到模块和复杂的先进 3D 封装,包含底填CUF封装胶水、液态塑封料LMC底部填充胶水、显示模组COF用底填封装胶水以及多种不同的低成本创新选项,研泰化学能提供丰富的倒装芯片底部填充胶水产品组合解决方案。

总而言之,底部填充胶是增强BGA组装可靠性的重要辅料,选择底部填充胶的好坏对产品可靠性有很大影响。如何选择与评估至关重要.研泰化学深耕电子胶粘剂行业十余载,研发的MX-62系列底部填充胶具有良好的耐冷热冲击、绝缘、抗跌落、低吸湿、低线性热膨胀系数、低粘度、流动性好、可返修等性能,广泛应用于通讯设备、仪器仪表、数码电子、汽车电子、家用电器、安防器械等行业。如您遇到电子行业用胶难题,例如为什么底部填充胶出现气隙等,欢迎通过在线客服、网站留言、来电、邮件等方式联系我们,研泰化学有专门的技术团队为您解决问题,将第一时间响应您的需求。